
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
توضیح کامل فرآیند ساخت تراشه (1/2): از ویفر تا بسته بندی و آزمایش
2024-09-18
ساخت هر محصول نیمه هادی به صدها فرآیند نیاز دارد و کل فرآیند تولید به هشت مرحله تقسیم می شود:پردازش ویفر - اکسیداسیون - فتولیتوگرافی - حکاکی کردن - رسوب لایه نازک - اتصال متقابل - تست کردن - بسته بندی.
![]()
مرحله 1:پردازش ویفر
تمام فرآیندهای نیمه هادی با یک دانه شن شروع می شوند! زیرا سیلیکون موجود در ماسه، ماده اولیه مورد نیاز برای تولید ویفر است. ویفرها برش های گردی هستند که از استوانه های تک کریستالی ساخته شده از سیلیکون (Si) یا آرسنید گالیم (GaAs) بریده شده اند. برای استخراج مواد سیلیکونی با خلوص بالا، ماسه سیلیس، ماده ای خاص با محتوای دی اکسید سیلیکون تا 95 درصد مورد نیاز است که ماده اولیه اصلی برای ساخت ویفر نیز می باشد. فرآوری ویفر فرآیند ساخت ویفرهای فوق است.
ریخته گری شمش
ابتدا ماسه باید حرارت داده شود تا مونوکسید کربن و سیلیکون موجود در آن جدا شود و این فرآیند تا زمانی که سیلیکون درجه الکترونیکی با خلوص فوق العاده بالا (EG-Si) بدست آید تکرار می شود. سیلیکون با خلوص بالا به مایع ذوب می شود و سپس به شکل جامد تک بلوری به نام "شمش" جامد می شود که اولین مرحله در تولید نیمه هادی است.
دقت ساخت شمش های سیلیکونی (ستون های سیلیکونی) بسیار بالا بوده و به سطح نانومتری می رسد و روش ساخت پرکاربرد روش Czochralski است.
برش شمش
پس از اتمام مرحله قبل، لازم است دو سر شمش را با اره الماسه بریده و سپس به ورقه های نازک با ضخامت معین برش دهید. قطر برش شمش اندازه ویفر را تعیین می کند. ویفرهای بزرگتر و نازکتر را می توان به واحدهای قابل استفاده تری تقسیم کرد که به کاهش هزینه های تولید کمک می کند. پس از برش شمش سیلیکون، لازم است که علامت های "ناحیه مسطح" یا "درخت" روی برش ها اضافه شود تا تنظیم جهت پردازش به عنوان استاندارد در مراحل بعدی تسهیل شود.
پرداخت سطح ویفر
برش هایی که از طریق فرآیند برش فوق به دست می آیند «ویفرهای لخت»، یعنی «ویفرهای خام» فرآوری نشده نامیده می شوند. سطح ویفر لخت ناهموار است و نمی توان الگوی مدار را مستقیماً روی آن چاپ کرد. بنابراین لازم است ابتدا عیوب سطح را از طریق فرآیندهای سنگ زنی و حکاکی شیمیایی از بین برده، سپس صیقل داده تا سطحی صاف ایجاد شود و سپس آلودگی های باقیمانده از طریق تمیز کردن حذف شود تا ویفر تمام شده با سطح تمیز به دست آید.
مرحله 2: اکسیداسیون
نقش فرآیند اکسیداسیون تشکیل یک لایه محافظ روی سطح ویفر است. ویفر را از ناخالصی های شیمیایی محافظت می کند، از ورود جریان نشتی به مدار جلوگیری می کند، از انتشار در حین کاشت یون جلوگیری می کند و از لیز خوردن ویفر در حین اچ جلوگیری می کند.
اولین مرحله از فرآیند اکسیداسیون حذف ناخالصی ها و آلاینده ها است. برای حذف مواد آلی، ناخالصی های فلزی و تبخیر آب باقیمانده به چهار مرحله نیاز است. پس از تمیز کردن، ویفر را می توان در محیطی با دمای بالای 800 تا 1200 درجه سانتیگراد قرار داد و یک لایه دی اکسید سیلیکون (یعنی "اکسید") از جریان اکسیژن یا بخار روی سطح ویفر تشکیل می شود. اکسیژن از طریق لایه اکسید پخش می شود و با سیلیکون واکنش می دهد و یک لایه اکسیدی با ضخامت های متفاوت تشکیل می دهد و ضخامت آن را می توان پس از اتمام اکسیداسیون اندازه گیری کرد.

اکسیداسیون خشک و اکسیداسیون مرطوب بسته به اکسیدان های مختلف در واکنش اکسیداسیون، فرآیند اکسیداسیون حرارتی را می توان به اکسیداسیون خشک و اکسیداسیون مرطوب تقسیم کرد. اولی از اکسیژن خالص برای تولید یک لایه دی اکسید سیلیکون استفاده می کند که کند است اما لایه اکسید نازک و متراکم است. دومی هم به اکسیژن و هم به بخار آب بسیار محلول نیاز دارد که با سرعت رشد سریع اما یک لایه محافظ نسبتاً ضخیم با چگالی کم مشخص می شود.
علاوه بر اکسیدان، متغیرهای دیگری نیز وجود دارد که بر ضخامت لایه دی اکسید سیلیکون تأثیر می گذارد. اول، ساختار ویفر، عیوب سطحی و غلظت دوپینگ داخلی آن بر میزان تولید لایه اکسید تأثیر می گذارد. علاوه بر این، هرچه فشار و دمای تولید شده توسط تجهیزات اکسیداسیون بیشتر باشد، لایه اکسید سریعتر تولید می شود. در طول فرآیند اکسیداسیون نیز لازم است از یک ورق ساختگی با توجه به موقعیت ویفر در واحد برای محافظت از ویفر و کاهش اختلاف درجه اکسیداسیون استفاده شود.
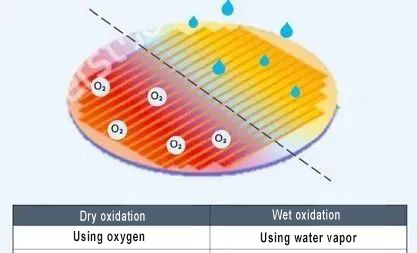
مرحله 3: فتولیتوگرافی
فوتولیتوگرافی عبارت است از "چاپ" الگوی مدار بر روی ویفر از طریق نور. ما می توانیم آن را به عنوان ترسیم نقشه صفحه مورد نیاز برای ساخت نیمه هادی بر روی سطح ویفر درک کنیم. هر چه ظرافت الگوی مدار بیشتر باشد، ادغام تراشه تمام شده بالاتر است، که باید از طریق فناوری پیشرفته فوتولیتوگرافی به دست آید. به طور خاص، فتولیتوگرافی را می توان به سه مرحله تقسیم کرد: مقاومت نوری پوشش، نوردهی و توسعه.
پوشش
اولین مرحله ترسیم مدار بر روی ویفر، پوشش دادن نور مقاوم بر روی لایه اکسید است. Photoresist با تغییر خواص شیمیایی ویفر را به یک "کاغذ عکس" تبدیل می کند. هرچه لایه مقاوم به نور روی سطح ویفر نازکتر باشد، پوشش یکنواختتر است و الگوی قابل چاپ ریزتر است. این مرحله را می توان با روش «پوشش چرخشی» انجام داد. با توجه به تفاوت در واکنش پذیری نور (ماوراء بنفش)، نور مقاوم ها را می توان به دو نوع مثبت و منفی تقسیم کرد. اولی پس از قرار گرفتن در معرض نور تجزیه می شود و ناپدید می شود و الگوی ناحیه در معرض نور باقی می ماند، در حالی که دومی پس از قرار گرفتن در معرض نور پلیمریزه شده و الگوی قسمت در معرض دید را نشان می دهد.
قرار گرفتن در معرض بیماری
پس از پوشاندن فیلم مقاوم به نور روی ویفر، چاپ مدار را می توان با کنترل قرار گرفتن در معرض نور کامل کرد. به این فرآیند "معروف شدن" می گویند. ما می توانیم به طور انتخابی نور را از تجهیزات نوردهی عبور دهیم. هنگامی که نور از ماسک حاوی الگوی مدار عبور می کند، مدار را می توان بر روی ویفر پوشش داده شده با فیلم فوتوریست زیر چاپ کرد.
در طول فرآیند نوردهی، هرچه الگوی چاپ شده ظریفتر باشد، تراشه نهایی میتواند اجزای بیشتری را در خود جای دهد، که به بهبود راندمان تولید و کاهش هزینه هر جزء کمک میکند. در این زمینه فناوری جدیدی که در حال حاضر بسیار مورد توجه قرار گرفته لیتوگرافی EUV است. گروه تحقیقاتی Lam به طور مشترک با شرکای استراتژیک ASML و imec یک فناوری جدید مقاوم در برابر نور فیلم خشک را توسعه داده است. این فناوری میتواند بهرهوری و بازده فرآیند قرار گرفتن در معرض لیتوگرافی EUV را با بهبود وضوح (یک عامل کلیدی در تنظیم دقیق عرض مدار) تا حد زیادی بهبود بخشد.
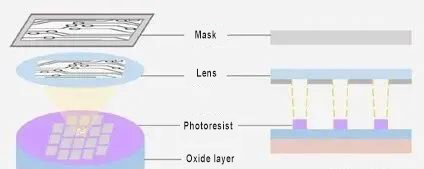
توسعه
مرحله بعد از نوردهی، اسپری کردن سازنده روی ویفر است، هدف از بین بردن مقاومت نوری در ناحیه بدون پوشش الگو است تا الگوی مدار چاپی آشکار شود. پس از تکمیل توسعه، باید توسط تجهیزات اندازه گیری مختلف و میکروسکوپ های نوری بررسی شود تا از کیفیت نمودار مدار اطمینان حاصل شود.
مرحله 4: اچ کردن
پس از اتمام فتولیتوگرافی نمودار مدار بر روی ویفر، از فرآیند اچ برای حذف هر لایه اکسید اضافی استفاده می شود و فقط نمودار مدار نیمه هادی باقی می ماند. برای این کار از مایع، گاز یا پلاسما برای حذف قسمت های اضافی انتخاب شده استفاده می شود. بسته به مواد مورد استفاده، دو روش اصلی برای اچ کردن وجود دارد: اچ کردن مرطوب با استفاده از یک محلول شیمیایی خاص برای واکنش شیمیایی برای حذف لایه اکسید، و اچ خشک با استفاده از گاز یا پلاسما.
حکاکی مرطوب
حکاکی مرطوب با استفاده از محلول های شیمیایی برای حذف لایه های اکسیدی دارای مزایای کم هزینه، سرعت اچ سریع و بهره وری بالا است. با این حال، حکاکی مرطوب همسانگرد است، یعنی سرعت آن در هر جهت یکسان است. این باعث می شود که ماسک (یا فیلم حساس) به طور کامل با فیلم اکسید حکاکی شده هماهنگ نباشد، بنابراین پردازش نمودارهای مدار بسیار ظریف دشوار است.

اچینگ خشک
اچینگ خشک را می توان به سه نوع مختلف تقسیم کرد. اولی حکاکی شیمیایی است که از گازهای اچ (عمدتا فلوراید هیدروژن) استفاده می کند. این روش مانند حکاکی مرطوب ایزوتروپیک است، یعنی برای اچ ریز مناسب نیست.
روش دوم کندوپاش فیزیکی است که از یون های موجود در پلاسما برای ضربه زدن و حذف لایه اکسید اضافی استفاده می کند. به عنوان یک روش اچ ناهمسانگرد، اچ کندوپاش دارای نرخ های مختلف اچ در جهت افقی و عمودی است، بنابراین ظرافت آن نیز بهتر از اچ شیمیایی است. با این حال، عیب این روش این است که سرعت اچ پایین است زیرا کاملاً متکی به واکنش فیزیکی ناشی از برخورد یون است.
روش سوم آخر، حکاکی یونی واکنشی (RIE) است. RIE دو روش اول را ترکیب می کند، یعنی در حالی که از پلاسما برای اچ فیزیکی یونیزاسیون استفاده می شود، اچ شیمیایی با کمک رادیکال های آزاد تولید شده پس از فعال شدن پلاسما انجام می شود. علاوه بر سرعت اچ بیش از دو روش اول، RIE میتواند از ویژگیهای ناهمسانگرد یونها برای دستیابی به حکاکی الگوی با دقت بالا استفاده کند.
امروزه، اچینگ خشک به طور گسترده ای برای بهبود بازده مدارهای نیمه هادی خوب استفاده می شود. حفظ یکنواختی اچینگ کامل ویفر و افزایش سرعت اچ بسیار مهم است و پیشرفته ترین تجهیزات اچ خشک امروزی از تولید پیشرفته ترین تراشه های منطقی و حافظه با کارایی بالاتر پشتیبانی می کنند.

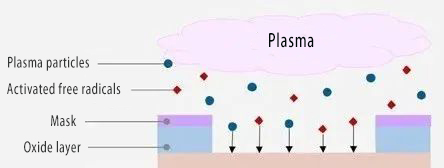
VeTek Semiconductor یک تولید کننده حرفه ای چینی استپوشش کاربید تانتالیوم, پوشش سیلیکون کاربید, گرافیت ویژه, سرامیک سیلیکون کاربیدوسایر سرامیک های نیمه هادی. VeTek Semiconductor متعهد به ارائه راه حل های پیشرفته برای محصولات مختلف SiC Wafer برای صنعت نیمه هادی است.
اگر به محصولات فوق علاقه مند هستید، لطفاً مستقیماً با ما تماس بگیرید.
موب: +86-180 6922 0752
Whatsapp: +86 180 6922 0752
ایمیل: anny@veteksemi.com




